Test machine lineup
Batch etching equipment
Available substrate sizes : 4 or 6-inch carrier × 2-cassette processing
Conveyance : Automatic conveyance, chuck system
Etching bath : 4-side overflow structure
Temperature adjusting function : Provided, 20°C to 80°C
Shaking mechanism : Provided, up-down (with a wafer rotation function)
QDR bath : With a shower function
Final rinse bath : With a specific resistance meter

Spin etching equipment
Available substrate sizes : 2, 3, 4, or 6 inches
For square substrates, please contact us.
Temperature adjusting function : Provided, max. 80°C
Chemical nozzle : 2 heads (One is a two-liquid mixing nozzle.)
Rinse nozzle : 1 head (capable of micro/nano bubbling)
Air blow : Provided
Chuck structure : Pin chuck
Chemical supply : Polyethylene tank
Chemical collection : Polyethylene tank

Lift-off equipment (1)
Available substrate sizes : 2 to 12 inches
For square substrates, please contact us.
High-pressure jet nozzle : Twin (vertical and oblique nozzles)
Jet pressure : 3 to 15 MPa (Temperature adjusting jet available, max. 100°C)
Paddle nozzle : Provided
Double-side rinse: Provided
Air blow : Provided
Chuck structure : Pin chuck or suction chuck
With a peeling chemical reuse system

Lift-off equipment (2)
Available substrate sizes : 2 to 8 inches
High-pressure jet nozzle : Twin (vertical and oblique nozzles)
Jet pressure : 3 to 20 MPa (Temperature adjusting jet available, max. 100°C)
Two-fluid nozzle : Provided
Paddle nozzle : Provided
Double-side rinse : Provided
Air blow : Provided
Chuck structure : Pin chuck or suction chuck
With an automatic chamber cleaning function
With a peeling chemical reuse system
With an automatic wafer conveyor robot

Peeling equipment (1), One-side overflow bath
Available substrate sizes : 2 to 12 inches (*8 inches for 15-wafer processing)
For square substrates, please contact us.
Temperature adjusting function : Provided, max. 100°C
Shaking mechanism : Up-down
Bath structure : One-side overflow structure
Chemical volume : About 35 L
Bubbling mechanism : Provided (peeling mode/ejection mode)
Ultrasonic function : Provided (frequency: 40 kHz; output: 600 W)
Filter circulation + ISF function
Suffix circulation function : Provided
Ultrasonic monitor : Provided

Peeling equipment (2), overflow bath with the DoM Jet System
Available substrate sizes : 2 to 8 inches (2 to 4 inches are available for two-cassette processing) For square substrates, please contact us.
Temperature adjusting function : Provided, max 100°C
Shaking mechanism: Up-down/side-to-side
Bath structure: One-side overflow structure
Chemical volume : About 65 L
Ultrasonic function : Provided (frequency: 38 kHz, 80 kHz, 120 kHz, 165 kHz; output: 600 W) Filter circulation + ISF function
Suffix circulation function : Provided
Ultrasonic monitor : Provided
USF (ultra-mesh filter) : Provided

QDR bath
Available substrate sizes : 2 to 6 inches One-cassette processing
Temperature adjusting function : No
Shaking mechanism : No
Bath structure : Four-side overflow structure
With an upper shower nozzle
Bath capacity : About 10 L
Bubbling mechanism : No
Ultrasonic function : No

Drying equipment: Spin dryer
Available substrate sizes : 2 to 8 inches
System : Opposing system
Rotating speed : Max. 800 rpm
Ionizer : Provided
HEPA unit : Provided
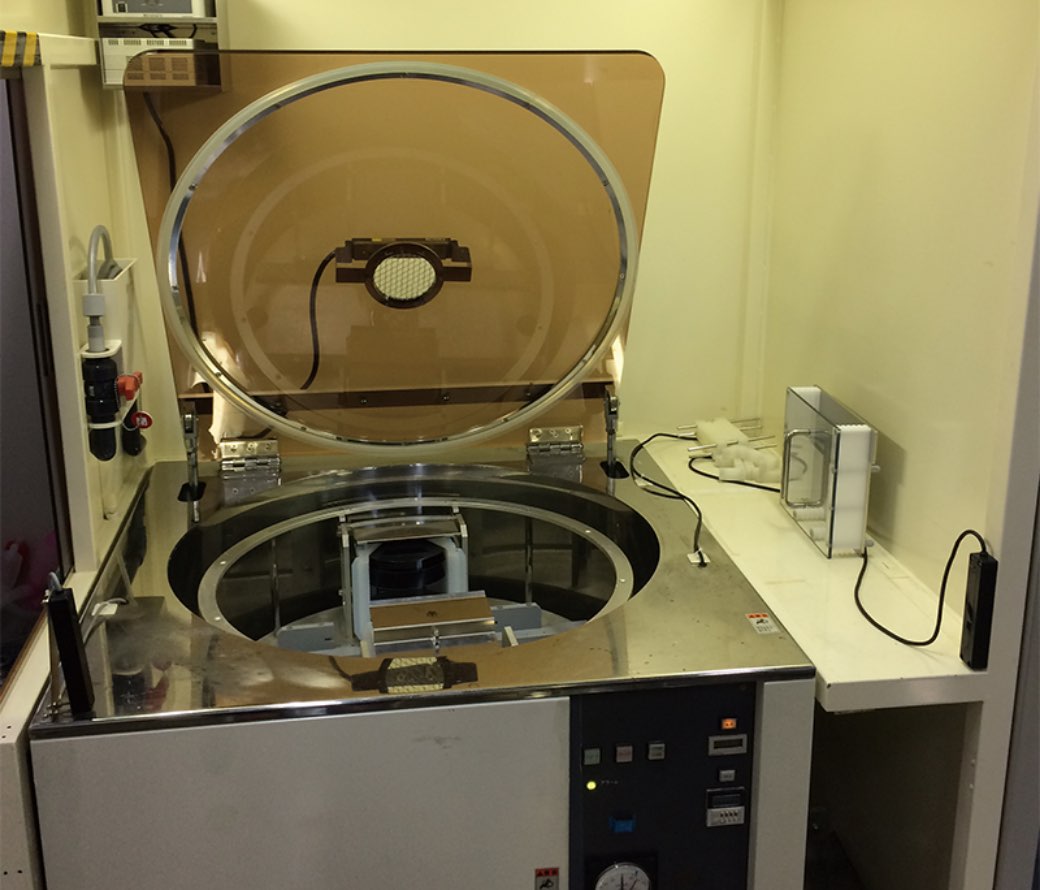
Tokyo Test Center
Dalton has a variety of testing machines where customers can select their equipment with a peace of mind.
Tokyo Test Center
Dalton Corporation
1-1-9, Narihira, Sumida-ku, Tokyo (on the premises of the Sumida Logix Co., Ltd.)
Zip code: 130-0002
- Honjo-azumabashi Station, Exit A2 (Toei Asakusa Line)
- Tokyo Skytree Station, Exit 1 (Tobu Skytree Line)
- Oshiage Station, Exit B2 (Tokyo Metro Hanzomon Line/Keisei Line)
(Seven to eight-minute walk from any of the stations above.
*20-30 minutes from Tokyo station)